如何看待华为Pura X搭载的麒麟9020芯片采用全新一体式封装工艺?
发布时间:
2025-03-31 22:09
阅读量:
14
我也看到这事了,先贴两张图吧:
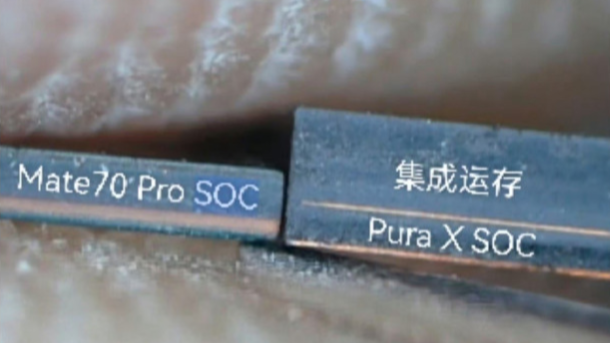

目前看Pura X采用了新的3D封装工艺,而且应该不是早期的POP方案。
这种工艺理论上需要前道和后道结合COW+WOS,台积电的命名是COWOS。
理论上新封装将SoC和运存集成在一起,有助于降低通信延迟和总体功耗,总体肯定是更先进。
而且这种3D封装整体更紧凑,能节省宝贵的机内空间,这点对小折叠这种寸土寸金的机器也很重要。
原本我担心新封装可能会加大散热压力,但目前看菊厂这边很可能也应用了TSV(硅通孔)技术。
TSV打孔穿板,可以让热流按设计方向循环,散热压力可能没有想象中那么大。
行业内AMD X3D系列也应用了类似技术,事实证明热干涉没有那么严重,果子的“统一内存”封装估计也是类似的东西。
如果要做个总结,那我个人观点是:
如果说麒麟9020代表着自主产线在先进制程领域的进步,那么Pura X的麒麟芯片就代表着国内产业链在先进封装领域的持续探索。
先进封装的战略意义和话题热度可能没有先进制程那么大,但仍然是未来国内半导体产业发展壮大过程中绕不过的一环。
而且麒麟芯片保持半年一迭代小步快跑,确实相当难得。
之前我在分析菊厂产业链布局的时候,曾经指出过一点:
对于终端产品来说,菊厂并不需要每一个环节都是最先进的(客观上也很难做到);
但菊厂只要站稳脚跟持续迭代,所有核心关节全部自主的垂直整合迟早能发挥出巨大的协同优势,进而一步步在消费者体验上实现领先甚至降维打击。
黄仁勋称华为是中国“最强大的”科技公司,因为,华为“在人工智能领域的实力逐年增强“。觉得这评价中肯吗?如今再看Pura X麒麟芯片的新封装结构,国内芯片设计厂、封装厂和内存厂的相互协同已经初现端倪。
Pura X已经如此,不知道Pura80系列是否还能有更新的进展,我拭目以待。
END